みなさんこんにちは、このブログを書いている東急三崎口です。
この記事は、長期連載の第6回として、半導体の真性キャリア密度について書いていきます。
本連載で扱っているのは、S.M.Sze著の半導体デバイス第2版の日本語訳verです。興味のある方は、下記リンク先から見てみてください。
前回の記事である、第5回はこちらです。

この記事のポイント
この記事で扱っているページおよび章は、下記のとおりです。
本記事で扱う内容と原著のぺージ
【内容】
・半導体の真性キャリア密度
【ページ】
・p31-34
原子の結合やエネルギーバンドを扱うので、理工系の大学生レベルの基礎知識が必要になってきます。
できるだけ、基礎知識が無くても読めるように情報を追加して書いていますが、原著が前提にしている背景知識は理工系の大学生レベルなのでご了承ください。
【ポイント】
・真性キャリア密度は、バンドギャップと温度で決まる
真性キャリア密度の定義
真性キャリア密度というと、半導体物理の勉強を始めると必ず通らないといけない内容かつ、最初に出てくるであろう内容です。
真性半導体(P型にもN型にもドーピングしていない半導体)の、キャリア密度について考えてみるわけです。
逐次、式変形で追っていきたい方は、いろいろな本に書いてあるので参照してみてください。(例えば、S.M.Szeの日本語版第2版のp31-33です。)
本の書き方は色々ありますが、よく書かれているのは真性半導体の電子密度を確かめたいので、「電子の状態密度」と電子の存在確立である「フェルミディラック分布関数」を掛けたものを、エネルギーで積分すればわかるでしょうという論理です。
この表現が、すんなりわかりやすければ良いんですが、初学者にとっては難しいポイントが3つあります。
・状態密度ってそもそも何?
・フェルミディラック分布関数って何者?
・そもそも、理論式の式変形についていけない
状態密度とフェルミディラック分布関数については、最初で出てきてわかりにくい割には、このあとあまり出てこないので、最終的な結果だけ知ったうえで読み進めた方が無難です。(大学の半導体物理の講義を受講している学生さんの場合は除きます。)
結局のところ、E-EF>3kTの条件を満たしていればという前提はつきますが、
np=ni2(n:電子密度、p:正孔密度、ni:真性キャリア密度)
ni=
という結論になります。
そして、このniは物質と温度で決まる物性値であることが重要です。
シリコンの場合、300K(約27℃)の時、9.65×109cm-3です。
真性キャリア密度で実用上重要なこと
シリコンの真性キャリア密度を考えるときに、実用上重要なのは式からわかるとおり、バンドギャップ(Eg)が大きくなるとniは減り、温度(K)が上がるとniは増えるということです。
バンドギャップは、基本的に物性値なので、物質が変わらなければ大きくは変わりません。(不純物濃度が上がったり、温度が大きく変わると若干変わりますが。)
バンドギャップはシリコンに限定すると大きく変わることはないので、温度の上下で真性キャリア密度が変わると考えて差し支えないでしょう。
Szeの本のp34、図22を見ると、100℃(373K)になればniは1×1012cm-3程度まで上昇することがわかります。
300Kで9.65×109cm-3だったことを考えると、73℃の上昇で2桁上がっていると言えます。
バンドギャップが2桁変わることはありえないので、真性キャリア密度は温度の影響を非常に強く受けるということを覚えておくことが大事です。
まとめ
この記事では、S.M.Szeを読み解く連載の第6回として半導体の真性キャリア密度について書きました。
前回の記事である、第5回はこちらです。

このブログでは、半導体に関する記事を他にも書いています。半導体メモリ業界が中心ですが、興味がある記事があれば読んでみてください。
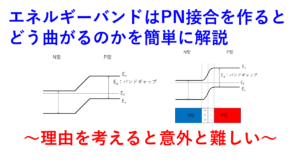
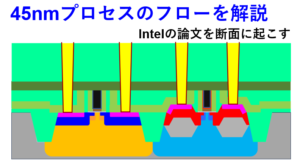
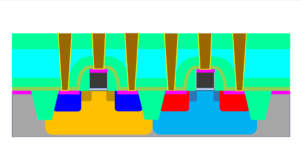
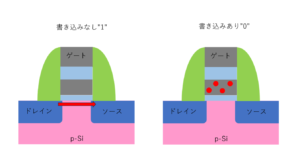

この記事はここまでです。最後まで読んでくださってありがとうございました。







コメント